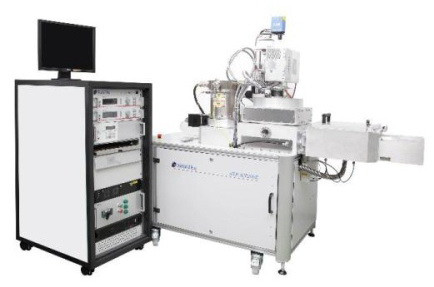
- Производитель
- Страна производительРоссия
Описание:
- Предельное остаточное давление в реакторе травления: <5•10¬6 мм.рт.ст.
- Количество одновременно обрабатываемых пластин:
- диаметром 2’’ - 7 шт.
- диаметром 3’’ – 4 шт.
- диаметром 100 мм – 1 шт.
- диаметром 150 мм – 1 шт.
- диаметром 200 мм - 1 шт.
- Максимальная мощность ВЧ-генератора (13,56 МГц) на RIE¬электрод (охлаждаемый столик образца), Вт: 600 (База), 1200 (Опция)
- Максимальная мощность ICP генератора (13,56 МГц), Вт: 1200 (База) 2500 (Опция)
- Однородность осаждения (травления) для пластины ∅100 мм: ±2% от центра
- Количество газовых линий в коррозионностойком исполнении в базе: 4шт.
Диаметр обрабатываемых пластин – до 200 мм, с возможностью использования образцов произвольной формы, что позволяет применять платформу как для прикладных исследований и разработок, так и для производственного выпуска продукции. Установки оснащены технологичной бесшовной алюминиевой камерой и новым шлюзовым устройством, позволяющим производить монтаж «через стену чистого помещения». Модернизированный реактор меньшего объема с продуманной системой подачи газов позволяет дополнительно оптимизировать однородность проведения процессов и снизить время откачки, что, в частности, оптимально для использования системы при проведении Boschпроцессов с быстрой сменой процессных газов. Проведение регламентных работ в реакторе стало значительно легче за счет удобного доступа ко всем внутренним узлам установки. Модернизированная конструкция рабочего стола обеспечивает эффективное гелиевое охлаждение для длительных процессов травления и прецизионный нагрев с термостабилизацией в исполнении для PECVD. Гибкие возможности для программирования технологического процесса позволяют реализовывать все современные способы нанесения диэлектриков без внесения повреждений в полупроводниковую структуру (“Low Damage Dielectric Deposition”).
В серии установок полностью реализованы все современные особенности процессов контролируемого плазмохимического травления полупроводниковых, диэлектрических и металлических слоев. Они одинаково применимы и для хлорной, и для фторной химии. Установки предполагают два типа возбуждения плазмы: емкостная (плоский водоохлаждаемый электрод) и индуктивная (плоский ICP¬источник). Главной отличительной особенностью систем является возможность комбинировать два режима плазмохимического травления: реактивное ионное травление и травление в индуктивно связанной плазме. Генераторы имеют автоматическое согласование, что обеспечивает получение устойчивых режимов горения плазмы в широком диапазоне используемых мощностей. Температурный диапазон для травления: –70°C (хладагент), +80°C (горячая вода). Конструкция установки обеспечивает возможность замены верхнего ICP электрода металлическим диском с отверстиями для подачи газа, что позволяет переконфигурировать установку травления в ICP и RIE плазме в упрощенный вариант установки травления в плазме только емкостного разряда и наоборот дооснастить упрощенный вариант ICP электродом.
